Более десяти лет назад, в конце 2014 года, когда ведущие мировые эксперты в области прикладного производства полупроводников из таких компаний, как IBM, ASML, Imec и Applied Materials, активно дискутировали о перспективах технологии EUV, только начинавшей тогда переход из лабораторий в производственные цеха, среди прочих способов усовершенствования глубокой ультрафиолетовой литографии (DUV) с длиной волны 193 нм часто обсуждалась технология направленной самосборки (directed self-assembly, DSA). Существуют различные подходы к её реализации — например, с использованием поверхностного натяжения несмешивающихся жидкостей, гравитационных сил или магнитных полей. Однако в микроэлектронике основное внимание уделялось DSA на основе специальных полимеров. Принцип заключается в следующем: сначала на кремниевой пластине создаётся относительно крупномасштабная направляющая структура (pre-pattern) с помощью доступных и экономичных DUV-установок. Затем на эту структуру наносится фоторезист, содержащий блок-сополимеры — макромолекулярные цепи, состоящие из чередующихся ковалентно связанных полимерных блоков (последовательностей мономеров) разного химического состава.
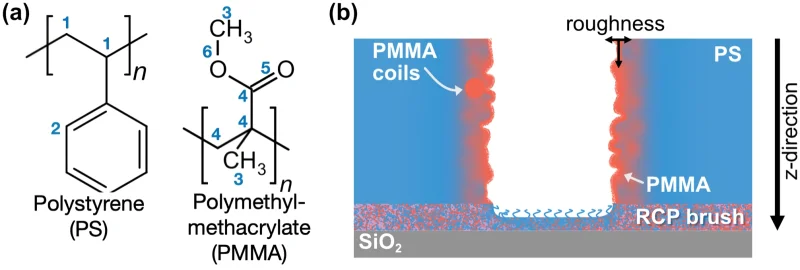
(a) — структурные формулы полистирола и полиметилметакрилата; (b) — схема поперечного сечения тонкой плёнки PS-b-PMMA, которая на подложке из двуокиси кремния, нейтрализованной RCP, формирует два PS-домена (источник: doi.org/10.1002/admi.202200962)
В качестве иллюстрации рассмотрим двухкомпонентный блок-сополимер — диблок-сополимер — состоящий из полиметилметакрилата и полистирола; PS-b-PMMA, poly(styrene-block-methyl methacrylate). Его составляющие, имея сильно различающиеся значения поверхностной энергии (в быту похожей несовместимостью обладают, например, вода и масло), стремятся отталкиваться друг от друга. На подложке с нейтральными физико-химическими свойствами они образовали бы тонкие, извилистые чередующиеся структуры — домены, — сформированные либо чистым полиметилметакрилатом, либо полистиролом, по морфологии напоминающие папиллярные узоры. Для осуществления направленной самосборки подложку предварительно структурируют, используя либо химический метод (chemoepitaxy; с нанесением «направляющих» из вещества, к которому притягивается один из компонентов диблок-сополимера благодаря своей поверхностной энергии), либо физический (graphoepitaxy; с созданием соответствующих канавок методом травления). После такой подготовки, когда на обработанную подложку наносится блок-сополимер, он формирует чёткие геометрические структуры — приподнятые линии, промежутки между ними, углубления с кольцевыми валиками и тому подобное. При этом, применяя для создания направляющих структур 193-нм лазеры, с помощью DSA в лабораторных условиях уже удаётся достичь физического минимального расстояния между центрами соседних металлических проводников в 12,5 нм (и теоретически это не предел) — тогда как для EUV-техпроцесса с маркетинговым обозначением «3 нм» аналогичный параметр равен 24 нм. Это звучит крайне привлекательно; однако почему-то и TSMC, и Samsung, и Intel продолжают вкладывать сотни миллионов долларов США в EUV-оборудование — и не проявляют готовности стимулировать скорейшее появление явно более экономичных установок DUV, усиленных технологией DSA. Что же сдерживает развитие столь многообещающего направления?
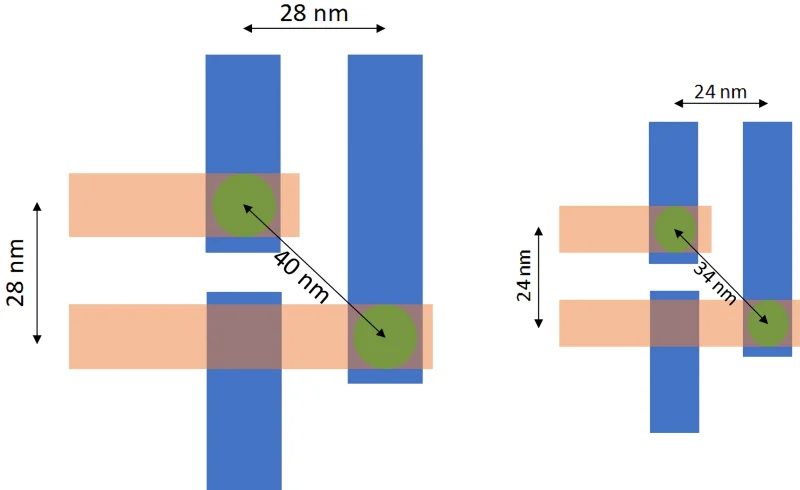
На левом изображении показан техпроцесс «5 нм»: здесь промежуток между центральными осями соседних проводящих дорожек равен 28 нм. При создании вертикальных соединений между такими слоями расстояние между центрами переходных отверстий увеличивается до 40 нм. Правая часть иллюстрирует аналогичную структуру для «3-нм» нормы: в пределах одного слоя оси проводников разнесены на 24 нм, а центры межслойных контактов отстоят друг от друга уже на 34 нм (источник: Proc. SPIE).
⇡#Несомненный прогресс!
Начнём с аргументации в пользу её потенциала: технология DSA изначально превосходит традиционную EUV-литографию по крайне важному показателю — среднему количеству дефектов на единицу площади создаваемого чипа. Причины, по которым уменьшение технологических норм ниже отметки «5 нм» ведёт к учащению подобных дефектов, мы уже обсуждали. Ключевой момент заключается в следующем: для правильного экспонирования фоторезиста на заданном участке необходимо передать ему определённую энергию. Чем меньше длина волны излучения, воздействующего на фоторезист, тем выше энергия каждого отдельного фотона — а значит, их требуется меньше для достижения нужного результата. Однако когда для засветки участка сверхтонкого элемента схемы требуется буквально десять-пятнадцать фотонов, в полной мере проявляется вредная стохастическая природа процесса: даже один-единственный фотон, случайно (хотя и в рамках статистической погрешности) отклонившийся от траектории, может исказить формируемую на подложке геометрию — и тем самым существенно снизить качество производимого полупроводникового наноустройства. Для норм «5 нм» стохастические эффекты EUV-процесса приводят к значительному разбросу рабочих параметров создаваемых на кремниевой пластине транзисторов, а начиная с «3 нм» фотоны, попадающие не туда, куда нужно, создают дефекты, сопоставимые по размеру с самими транзисторами — обрывы проводящих путей, слияние соседних контактов и тому подобное. В итоге при массовом производстве тех же «3-нм» чипов до половины всех производственных браков обусловлено именно стохастическим поведением фотонов.
Следует учитывать, что по мере уменьшения размеров отдельных полупроводниковых компонентов влияние случайных факторов лишь усиливается: неопределённость является неотъемлемой чертой квантовых систем, поэтому физически невозможно каким-либо образом «сфокусировать» поток одиночных фотонов, близких к рентгеновским (с длиной волны 13,5 нм), чтобы отдельные частицы не отклонялись значительно от общего направления пучка. В то же время недостатки технологии направляемой самосборки (DSA), из-за которых около десяти лет назад её перестали рассматривать как основной путь развития микроэлектронного производства, в основном носят технический характер и потому могут быть устранены. Более того, эти проблемы можно решать не параллельно с развитием современной EUV-фотолитографии, то есть не требуя отдельных бюджетов, а совместно с ней, используя направляемую самосборку для исправления тех самых неизбежных стохастических дефектов, которые становятся серьёзной проблемой в технологических процессах вблизи маркетингового «нанометрового» рубежа. При таком подходе структуры, созданные в процессе EUV-экспонирования и травления, служат направляющими для полимерных цепей в DSA — и уже поверх них (скрывающих стохастические дефекты EUV-паттернинга, подобно штукатурке, маскирующей неровности кладки) на следующих этапах изготовления полупроводниковой схемы наносится очередной слой.
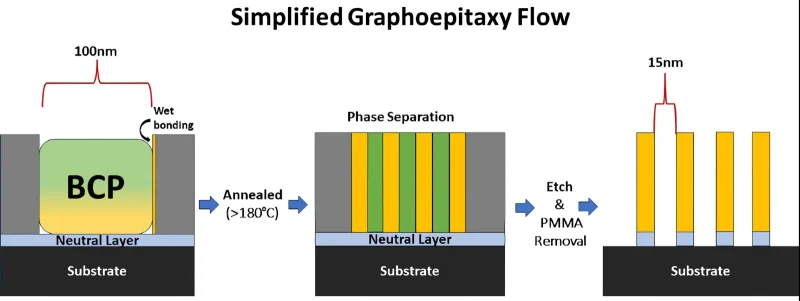
Упрощённая схема графоэпитаксиальной направляемой самосборки, которая позволяет на сформированных методами классической литографии заготовках с характерным шагом в 100 нм получать высокоупорядоченные структуры с зазорами в 15 нм между соседними элементами (источник: Semiconductor Engineering)
Так в чём же скрыта основная сложность; что может пойти не так при использовании направленной самосборки? Отчасти здесь также присутствует элемент случайности — но уже на стадии образования молекул блок-сополимера. Эти молекулы сформированы из чередующихся гидрофильных и гидрофобных сегментов: именно силы отталкивания между этими участками и способствуют созданию прямых (не склонных к самопроизвольному изгибу и спутыванию) протяжённых «нитей» предельно малой толщины. Чем значительнее различие поверхностных энергий соседних блоков, тем короче могут быть эти сегменты без утраты их химических характеристик и, как следствие, тем мельче характерный размер структур, которые можно получить в процессе DSA с такими молекулами. Однако если поверхностные энергии окажутся чрезмерно разными, ковалентным связям между блоками будет сложнее противостоять взаимному отталкиванию, что станет причиной разрывов цепей и нарушения упорядоченности мезоструктур блок-сополимера. И хотя химические методы производства в целом более эффективны, чем физические (если удаётся найти, отладить и масштабировать процесс синтеза нужных молекул в промышленных объёмах, это оказывается гораздо экономичнее и проще, чем достигать аналогичных целей средствами прецизионного инжиниринга), полимерная химия тоже ставит перед учёными немало трудных задач. И разработчики были готовы справляться далеко не со всеми из них, пока основной путь развития микроэлектроники — EUV-фотолитография — казался требующим в основном экстенсивного наращивания ресурсов, практически гарантируя результат благодаря пресловутому «закону Мура».
⇡#С практической точки зрения
Как отмечалось ранее, существует два основных метода формирования на кремниевой подложке структур направляемой самосборки (DSA) на основе блок-сополимеров: графоэпитаксия и хемоэпитаксия. При графоэпитаксии поверхность предварительно структурируют методами традиционной фотолитографии, но с разрешением, в несколько раз (от 2 до 5) превышающим целевое, которое в итоге задаёт характерный размер конечных полупроводниковых элементов. Образованные в результате такой разметки углубления заполняют блок-сополимером. Последующий отжиг (нагрев выше 180 °C) приводит к фазовому разделению материала. При этом именно характерный размер блоков PS-b-PMMA (если рассматривать данный диблок-сополимер) определяет ключевой физический параметр — шаг (pitch), то есть расстояние между центрами соседних элементарных структур в итоговой микросхеме. Здесь есть свои технологические нюансы (дно «траншей» не должно взаимодействовать ни с одним из компонентов сополимера, тогда как на одной из стенок, напротив, необходимо специальное покрытие, прочно связывающееся с одним из них), однако в целом процесс выглядит логичным и относительно простым.
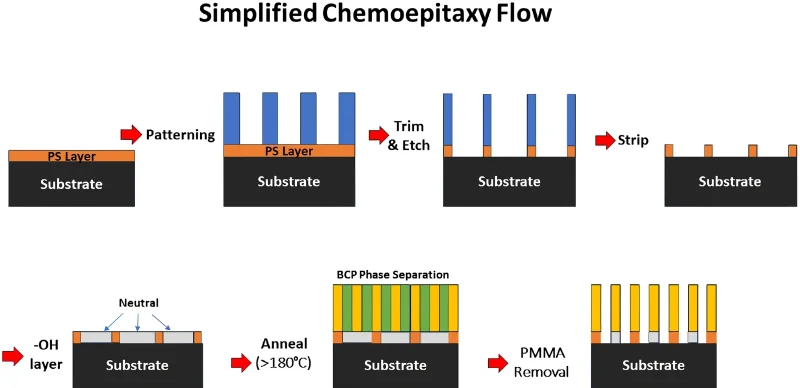
Упрощённая схема хемоэпитаксиальной направляемой самосборки (источник: Semiconductor Engineering)
Хемоэпитаксиальный подход имеет свою специфику: для создания «столбиков» из чередующихся компонентов блок-сополимера сначала формируют направляющий шаблон. На нём попеременно располагаются области с различной поверхностной энергией, к которым впоследствии самопроизвольно прикрепляются соответствующие молекулярные блоки. Технология включает нанесение на подложку тонкого слоя полистирола, его селективное травление через маску фотолитографическими методами, нанесение блок-сополимера, удаление полиметилметакрилата и окончательное травление структуры до основы. В этом случае физическое разрешение комбинированного процесса DUV+DSA также многократно превосходит возможности оборудования, использующего только DSA, и приближается к показателям установок EUV-литографии (по крайней мере, первого поколения, ориентированного на нормы 5 и 3 нм, а не более продвинутых High-NA систем). Кто знает — информация, разумеется, не публичная, — возможно, именно благодаря направляемой самосборке на завершающем этапе производства китайская полупроводниковая отрасль смогла за последний год добиться значительных успехов в освоении 7-нм техпроцесса с перспективой перехода на 5 нм, используя оборудование DUV? Во всяком случае, именно китайские учёные в последнее время проявляют к теме DSA особо активный интерес.
Разнообразие геометрических структур, формируемых на поверхности, определяется соотношением длин полимерных цепей полистирола (PS) и полиметилметакрилата (PMMA) в диблок-сополимере. Приблизительно одинаковые по длине цепи способствуют образованию параллельных рядов узких и высоких пластин, идеально подходящих, например, для создания гребней транзисторов FinFET. Изменяя пропорции длин мономеров PS и PMMA, можно получать упорядоченные цилиндрические образования, которые в дальнейшем служат основой для «колодцев» в ячейках памяти NAND. Это лишь фундаментальные принципы процесса направленной самоорганизации (DSA); применение различных полимеров, методик и многослойных архитектур открывает перед экспериментаторами ещё более широкие горизонты. Исследователей особенно вдохновляет то, что даже при неидеальном исполнении направляющих структур, блок-сополимеры в силу законов химической физики всё равно стремятся к формированию почти безупречных упорядоченных конфигураций. С этой позиции хемоэпитаксиальный метод выглядит даже более перспективным: хотя он требует больше времени и усилий, он не предъявляет столь жёстких требований к физическим размерам предварительно создаваемых «траншей» и к точному нанесению специфических химических агентов на их стенки.
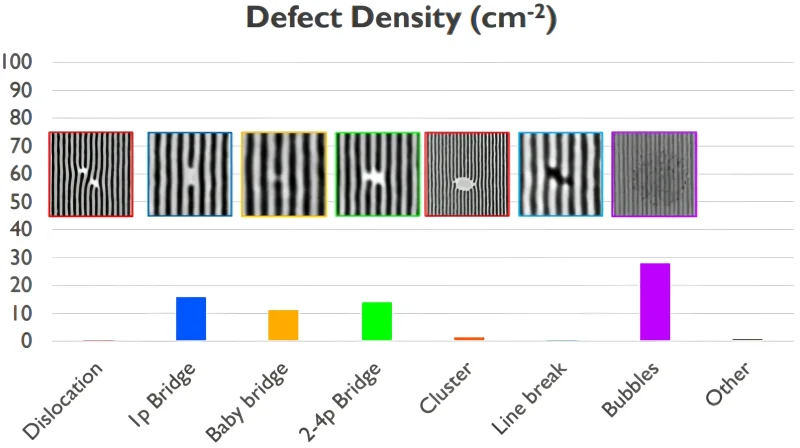
Плотность (ед./кв. см) дефектов различного типа — их внешний вид проиллюстрирован на изображениях выше — для процесса DSA на фотолитографической направляющей структуре с «13-нм» технологическими нормами (источник: Imei)
С таким обнадёживающим посылом вернёмся к изначальному вопросу: почему же технология DSA не находит повсеместного применения — если не в качестве замены EUV, то хотя бы для поддержки действующих DUV-литографов, которые уже сейчас могли бы производить столь необходимые рынку чипы (особенно DRAM и NAND) по более тонким техпроцессам? К сожалению, в полупроводниковой отрасли зрелость технологии часто напрямую зависит от времени её развития, а DSA ещё очень молода: серьёзный интерес к ней как к практическому решению возник, напомним, лишь в начале XXI века. Даже такая многообещающая методика, как хемоэпитаксия, сталкивается с проблемой отсутствия отработанных методов получения сверхчистых реагентов, а также с необходимостью строго контролировать поверхностную энергию на каждом участке полимерных цепей и подложек. Для сравнения: в микроэлектронике промышленный стандарт для жизнеспособного процесса предполагает стабильный уровень дефектов менее одного на квадратный сантиметр. У DSA же насчитывается около десятка различных типов дефектов, и для каждого из них плотность может достигать почти 30 на см². Практически на каждой стадии — будь то поддержание точной температуры отжига, обеспечение равномерной толщины наносимых плёнок по всей площади, контроль химической активности травильных растворов и т.д. — этот деликатный процесс чувствителен к малейшим отклонениям параметров, что и приводит к столь высокому количеству брака.
⇡#И всё-таки она выравнивается
Помимо значительного, хотя и временного, уровня дефектов (а их устранение, в отличие от квантовой стохастики высокоэнергетических EUV-фотонов, — вопрос времени и доработок, как уже отмечалось), у технологии направленной самоорганизации (DSA) существует ещё одно прикладное ограничение. Дело в том, что она идеально подходит для создания жёстко упорядоченных конфигураций, таких как регулярные массивы узких «плавников» или безупречно расположенные по узлам квадратной сетки цилиндрические углубления. Однако логические схемы требуют гораздо более сложного пространственного размещения элементов, где дистанция между одними соседними компонентами должна отличаться от расстояния между другими. Здесь DSA, именно как недорогой, химический (в противовес фотолитографическому, инженерному) метод массового производства микроструктур, явно проявляет свою слабость. Обнадёживает, впрочем, что для чипов памяти такая высокая степень упорядоченности полупроводниковых элементов, достигаемая практически автоматически, без применения сложного оборудования, — настоящее благо. Это вновь вселяет надежду, что производители DRAM-памяти, которым в ближайшие годы в любом случае предстоит срочно наращивать производственные мощности, не станут экономить на инвестициях в развитие столь экономичного (в перспективе, после его окончательной доводки) способа продлить эффективный срок службы объективно устаревающих DUV-установок.
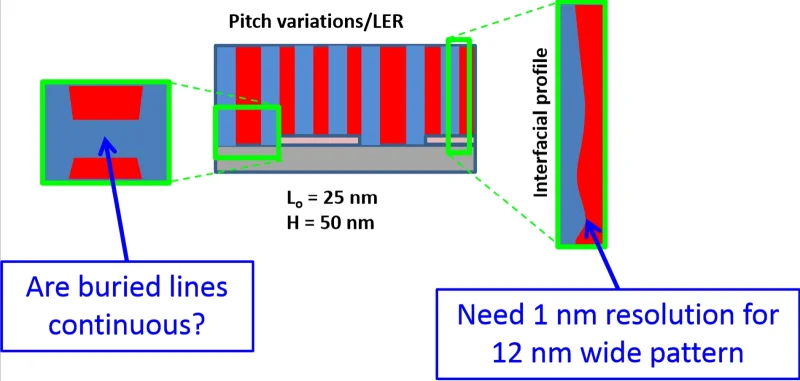
В толще сформированной методом DSA структуры могут возникать — и, увы, на практике действительно возникают — разнообразные дефекты, обнаружить которые не так-то просто (источник: NIST)







